目前,国内外已有不少科研机构开发和研究了高热导率、低热膨胀系数及低密度的复合电子封装材料,并且已经在电子封装领域开始大批量使用,铝基碳化硅(AlSiC)、铝基金刚石(Al/Dia)、铜基金刚石(Cu/Dia)等新型的电子封装材料的性能比前几代封装材料要优越不少。

新型电子封装材料与其他封装材料的性能表(图一)
在电子封装领域,通常把单质金属材料(如铜、铝)、陶瓷、高分子塑料材料叫做第一代封装材料,它们因其本身的性能特点而使用到电子领域,但也因为本身固有的弊端而限定了它们的使用范围和应用缺陷。如图一中的Cu、Al、Al2O3、AlN等,各有优缺点,无法实现应用到理想的应用场景。
第二代的封装材料是两种及以上的金属的复合材料,如可伐合金、钨铜合金(图二)、钼铜合金(图三)等等,为了最大发挥金属材料的散热应用场景,甚至做成铜-钼-铜CMC材料(图四),铜-钼铜-铜CPC材料(图五)等。

W-Cu钨铜材料的性能表(图二)
钨铜材料是一种钨和铜的复合材料,它既具有钨的低膨胀特性,又具有铜的高导热特性,其热膨胀系数和导热导电性能可以通过调整材料的成分而加以设计。钨铜材料可以与陶瓷材料、半导体材料、金属材料等形成良好的热膨胀匹配,主要应用射频、微波、半导体大功率封装、光通信等行业。

MoCu钼铜材料性能表(图二)

Mo-Cu钼铜材料性能表(图三)
钼铜Mo-Cu材料是钼和铜的复合材料,其性能与钨铜相似,同样具有可调的热膨胀系数和热导率。但钼铜的密度比钨铜小很多,因而更适合于航空航天等领域。产品纯度高,组织均匀,性能优异。由于使用的Mo-Cu材料不加任何粘接剂,材料具有很高的导热率,热膨胀率与电子工业的陶瓷材料和半导体材料相匹配,通过Mo-Cu冲压和大批量生产节约成本,机加工性能好。钼铜材料比钼更耐烧蚀,更具有塑性和可加工性,可以用作使用温度稍低的火箭、导弹的高温部件,也可替代钼作为其他武器中的零部件。大功率的集成电路和微波集成器件要求高电导热导材料作为导电散热元件,同时又要兼顾真空性能、耐热性能及热膨胀系数等。钼铜的各项特性符合这些要求,是这方面的优选材料。

铜-钼-铜(CMC)材料性能表(图四)
铜钼铜(CMC)封装材料是一种三明治结构的平板复合材料,它采用纯钼做芯材,双面再覆以纯铜或者弥散强化铜。这种材料的热膨胀系数可调,热导率高,耐高温性能优异。生产工艺一般采用轧制复合,电镀复合,爆炸成形等方法加工制备的。主要在电子封装中用作热沉、引线框和多层印刷电路板(PCB)的底膨胀与导热通道。

铜/钼铜/铜(CPC)材料性能表(图五)
与铜/钼/铜(CMC)相似,铜/钼-铜/铜(CPC)材料也是三明治结构,它是由两个副层-铜(Cu)包裹一个核心层-钼铜合金(MoCu),它在X区域与Y区域有不同的热膨胀系数,相比钨铜、钼铜和铜/钼/铜材料,铜/钼铜/铜(Cu/MoCu/Cu) 导热率更高,价格也相对有优势。
铜/钼铜/铜(CPC)电子封装材料优点:
1. 比CMC有更高的热导率
2. 可冲制成零件,降低成本
3. 界面结合牢固,可反复承受850℃高温冲击
4. 可设计的热膨胀系数,与半导体和陶瓷等材料相匹配
5. 无磁性
第三代封装材料是铝基碳化硅(AlSiC)、铝硅(AlSi)、铝金刚石(Al-Dia)、铜金刚石(Cu-Dia)等金属基热管理复合材料的统称,是电子元器件专用封装材料,主要是指将金属与一种非金属材料按照相对应的体系来进行复合的材料;该材料既有金属的性能,又有非金属(陶瓷、硅颗粒、金刚石)材料的性能。主要特行为:高导热、高刚度、高耐磨、低膨胀、低密度、低成本等。这些特性不只针对电子封装有革命性意义,也可被分别应用于不同的领域。

铝基碳化硅材料(AlSiC)(图六)
铝基碳化硅(AlSiC)材料(图六)是陶瓷碳化硅颗粒增强铝基复合材料(又称铝渗碳化硅),是在真空环境下用压力将铝液渗入碳化硅预制型中,使合金的显微结构发生变化,引起合金性能发生变化,从而使复合材料的强度等性能显著提高的一种金属复合材料。具有低密度(小于3.1g/cm3)、高强度、高比模量、低膨胀系数,尺寸稳定性高等优点,与一些传统材料相比,铝碳化硅复合材料性能更加优越,可替代多种传统材料。
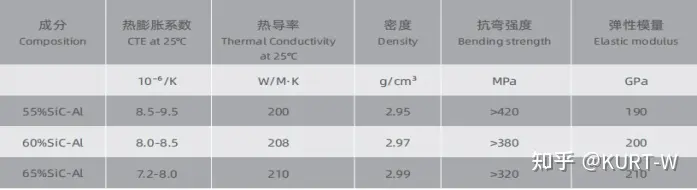
铝基碳化硅(AlSiC)材料性能表(图七)(材料可以表面处理,镀金,银,镍等)
铝基碳化硅(AlSiC)材料应用方向(图八、图九、图十)

铝基碳化硅(AlSiC)集成电路芯片封装盖板应用(图八)

铝基碳化硅(AlSiC)大功率IGBT模块应用散热底板(图九)

铝基碳化硅(AlSiC)SiC模块应用散热底板(图十)
铝硅AlSi材料(图十一)也是一种金属基复合材料,充分利用铝和金属硅的性能,主要用于航空航天封装管壳。虽然其热导率略逊于铝碳化硅,但其硬度较低,机加工性能优于铝碳化硅。含硅量27%,42%,50%,60%及70%,主要用于电子封装,在微波功率器件,集成功率模块,T/R模块等电子功率器件的封装中发挥出优异的性能。利用高硅铝合金作为电子封装材料的基座,外壳,盒体,盖板,匹配性好,可提供更好的散热,能极大的延长封装大功率模块的使用寿命,可靠性增加。该材料具有重量轻,(密度2.4—2.7克/立方厘米),高热导性,低热膨胀,高刚度,良好的机械加工与表面镀覆性能以及焊接性能,材料致密性好,耐高温,耐腐蚀等特点。
我们可以提供从研发,生产,后期机加工,电镀等一系列电子封装服务。

铝硅AlSi材料封装管壳(图十一)

硅铝(AlSi)材料的性能表(图十二)
铜金刚石Cu/Dia,是一种金刚石粉与铜合金的复合材料。采用优质人工合成金刚石粉,其具有1000W/M.K左右的热导率,和极低
的热膨胀系数,合适的工艺下,金刚石颗粒与铜合金达成冶金结合界面,则金刚石铜复合材料具有极佳的热导率与合适的热膨胀系数。
铝金刚石Al/Dia,与金刚石铜类似,密度更低,但热导率略逊色于金刚石铜。
金刚石铜、金刚石铝是目前性能最佳的散热材料。(单晶金刚石及CVD金刚石热导率高,但热膨胀系数太小;碳纤维复合材
料热膨胀/热导性能具有方向性)。

铜金刚石Cu/Dia,铝金刚石Al/Dia的散热片应用(图十三)
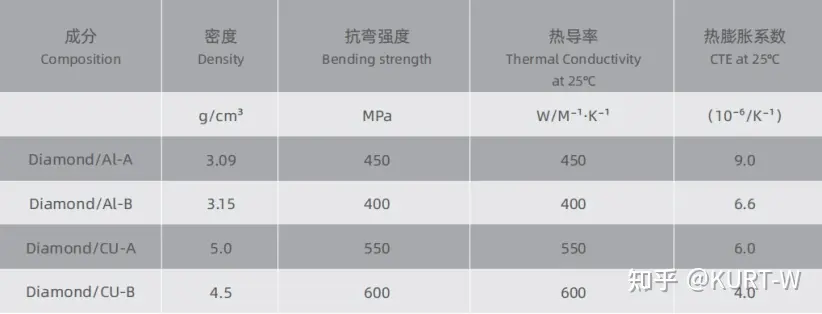
铜金刚石Cu/Dia,铝金刚石Al/Dia材料的性能表(图十四)
可以根据客户的要求,提供从研发,生产,后期机加工,电镀等一系列电子封装服务,欢迎交流。
来源:未知
①凡本网注明"信息来源:热传商务网"的所有文章,版权均属于本网,未经本网授权不得转载、摘编或利用其它方式使用。
②来源第三方的信息,本网发布的目的在于分享交流,不做商业用途,亦不保证或承诺内容真实性等。如有侵权,请及时联系本网删除。联系方式:7391142@qq.com
 热传商务网-热传散热产品智能制造信息平台
热传商务网-热传散热产品智能制造信息平台



